TSMC에 10년 뒤처진 삼성전자…추격 '승부수' 던졌다 [황정수의 반도체 이슈 짚어보기]
-
기사 스크랩
-
공유
-
댓글
-
클린뷰
-
프린트
AI 반도체 시대에 중요한 '패키징'
D램, GPU 등 '하나의 반도체'로 동작
TSMC, 10년 전부터 기술 개발
엔비디아 GPU 독점 비결
"캐파 부족해서 주문 못 받아"
삼성전자도 추격에 속도
첨단 패키징 서비스 시작
D램, GPU 등 '하나의 반도체'로 동작
TSMC, 10년 전부터 기술 개발
엔비디아 GPU 독점 비결
"캐파 부족해서 주문 못 받아"
삼성전자도 추격에 속도
첨단 패키징 서비스 시작

최근 반도체산업에서 중요성이 커지고 있는 '패키징' 경쟁력에 대한 국내 전문가들의 진단이다. 패키징은 전(前)공정을 과정에서 생산된 칩을 기기에 장착할 수 있는 상태로 가공하는 것이다. 최근 전공정에서 '칩 미세화'의 어려움이 커지면서 반도체기업들은 후(後)공정에 속하는 패키징 기술을 통해 칩 성능을 높이는 데 주력하고 있다.
D램, GPU, CPU '한 칩' 처럼 동작하게 묶는 '패키징'이 관건
생성형 인공지능(AI)을 위한 서버용 그래픽처리장치(GPU)의 중요성이 커지면서 패키징에 대한 관심이 커지고 있다. 그중에서도 GPU, D램 등 서로 다른 반도체들을 하나로 결합하는 '이종(異種·heterogeneous) 패키징' 능력이 반도체기업 기술력을 가르는 척도로 꼽히고 있다.챗 GPT 같은 생성형 AI 기술 고도화를 위해선 대규모 데이터를 빠르게 학습하고 이를 활용해 서비스하는 게 중요하다. 이를 위해 필요한 게 반도체다. 대표적으로 대용량 데이터의 학습을 담당하는 그래픽처리장치(GPU), 데이터를 저장하고 GPU와 소통하는 D램의 수요가 커지고 있다. GPU 세계 1위 엔비디아와 고용량 D램을 만드는 삼성전자, SK하이닉스가 'AI 시대 수혜 주'로 부각된 이유다.
HBM과 관련해선 7월 22일 한경닷컴 기사 '이대로면 큰일' 삼성도 초긴장…SK하이닉스, 심상치 않네'를 통해 살펴봤다. 첨단 패키징 분야에선 국내 전문가들이 인정할 정도로 대만 TSMC가 앞서가고 있다. TSMC는 엔비디아의 주문을 받아 직접 생산한 GPU, SK하이닉스에서 받은 HBM D램을 패키징해 엔비디아에 최종 공급한다.
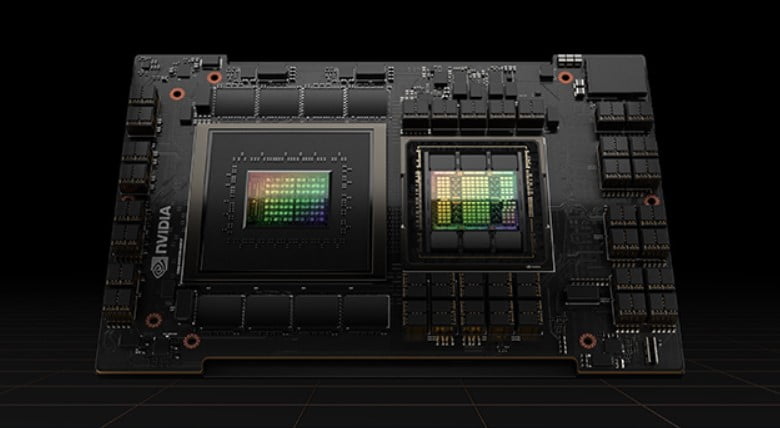
첨단 패키징 앞서 나가는 TSMC, 삼성은 2021년에서야 공개
현대차증권의 보고서 '반도체 후공정: AI 산업과 Advanced Packaging'을 보면 TSMC는 2011년부터 2021년까지 10년간 5세대에 걸쳐 2.5D 패키징을 발전시켰다. 이 10년 동안 인터포저(이종 칩 간 연결과 고속통신을 가능하게 하는 부품)사이즈는 3배 이상, 트랜지스터 집적도 20배, 메모리용량은 8배 이상 증가했다.최근엔 TSMC의 2.5D 패키징 생산능력(캐파)이 부족해 엔비디아가 GPU를 고객사에 제때 공급하지 못하는 상황까지 왔다. 앞서 설명한 대로 엔비디아는 TSMC에 GPU 생산을 맡기고, SK하이닉스에서 HBM을 사서, 이 칩들을 TSMC가 패키징해 최종 완성한다. 그런데 TSMC의 패키징 용량이 엔비디아 GPU 수요를 못 따라잡다 보니 '품귀' 현상까지 발생했다는 것이다.
TSMC는 최근 열린 2분기 실적설명회에서 "AI 열풍으로 패키징 캐파가 부족해졌다"며 "첨단(2.5D) 패키징 용량을 내년까지 2배 늘릴 계획"이라고 발표했다. 외신에 따르면 TSMC는 900억대만달러(약3조 7000억원)를 투자해 대만 북부에 첨단 패키징 시설을 설립할 계획이다. 현대차증권에 따르면 TSMC의 첨단 패키징 용량은 올해 웨이퍼(반도체 원판) 기준 12만장에서 내년 21만장으로 증가할 것으로 예상된다. 그러면 엔비디아의 GPU 출하량도 올해 140만개에서 내년엔 260만개로 늘어나게 된다.
삼성도 'I-Cube' 등 첨단 패키징 육성에 팔 걷어
삼성전자도 첨단 패키징 육성에 팔을 걷어붙였다. 지난해 말 조직개편을 통해 반도체사업을 담당하는 디바이스솔루션(DS)부문 직속 AVP(첨단패키징)팀을 신설했다. 내년 2분기부터는 4개의 HBM을 GPU 등과 함께 배치한 '아이큐브 4'를 양산하고 3분기엔 8개의 HBM을 배치한 아이큐브 8을 양산한다.12개, 16개의 HBM을 배치하는 제품도 개발 중인 것으로 알려졌다. 구글, 마이크로소프트, 메타 같은 고객사들이 대용량 데이터 처리를 위해 D램 용량을 늘려 달라고 요구하고 있고, 이를 위해 D램을 수직으로 쌓은 HBM도 더 많이 패키징하려는 것이다.

메모리, 파운드리, 패키징 원스톱 제공 '턴키 서비스' 시작
메모리반도체 생산, 파운드리, 패키징 등의 사업을 모두 다 하는 '종합반도체기업'으로서의 장점을 발휘하는 데도 주력한다. 파운드리사업부 주도로 고객사에 '패키징 원스톱 서비스'를 제공하겠다고 선언한 게 대표적인 사례로 꼽힌다.
황정수 기자 hjs@hankyung.com



![K팝 업계에도 '친환경' 바람…폐기물 되는 앨범은 '골칫거리' [연계소문]](https://img.hankyung.com/photo/202206/99.27464274.3.jpg)


